——精準檢測,高效解決,助力產品可靠性提升
背景介紹
LED作為現代照明和電子設備的核心組件,其穩(wěn)定性和可靠性直接影響用戶體驗。近期,我們收到客戶反饋:LED點燈不亮,但外觀無異常。此類隱蔽性故障對檢測技術和問題分析能力提出了極高要求。憑借先進的設備與專業(yè)團隊,我們迅速定位問題根源,并制定針對性解決方案,確保客戶產品品質。
問題分析與檢測流程
1、初步排查:外觀檢查
目視檢測未發(fā)現封裝破損、焊點脫落等明顯異常(如下圖)。
初步排除外部機械損傷或工藝疏漏的可能性。
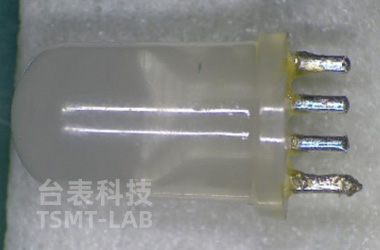
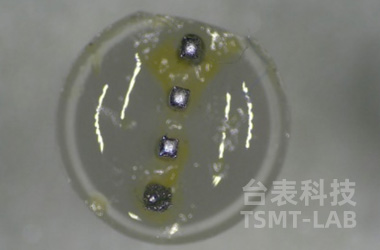
2、深入檢測:X-ray與電性測試
X-ray成像:發(fā)現第二打點位置金線斷裂(圖4-7),導致電路開路。
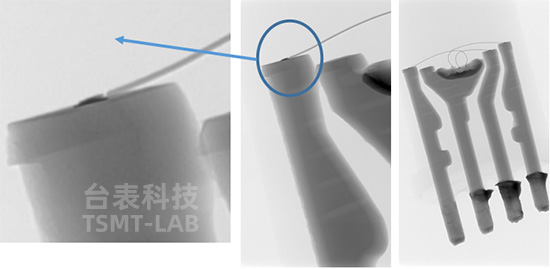
VF量測:確認開路狀態(tài),驗證金線斷裂對電流路徑的阻斷作用。

3、微觀驗證:切片與SEM分析
切片檢測:金線斷裂處微觀形貌清晰可見,斷裂面呈現脆性特征。
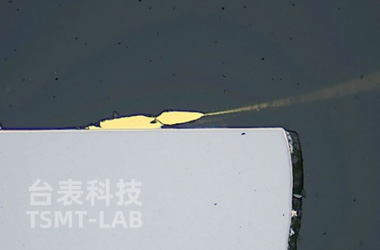
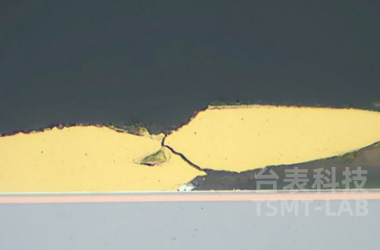
電子顯微鏡(SEM):進一步分析斷裂原因,發(fā)現焊接工藝缺陷(如溫度波動或應力集中
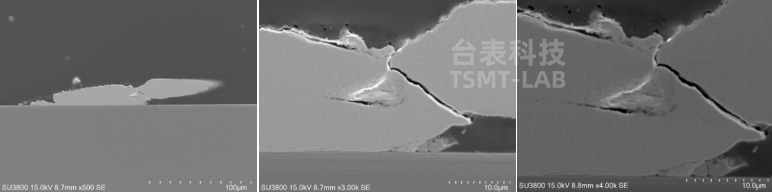
失效原因總結
核心問題:金線焊接工藝不良,導致第二打點處斷裂。
潛在因素:
焊接溫度或壓力控制不當;
封裝過程中機械應力集中;
材料熱膨脹系數不匹配。
解決方案與優(yōu)化措施
1、工藝改進
優(yōu)化焊接參數(溫度、壓力、時間),采用高精度焊線機;
引入自動化光學檢測(AOI)實時監(jiān)控焊線質量。
2、材料升級
選用延展性更強的金線材料,提升抗應力能力;
優(yōu)化封裝膠體配方,減少熱應力影響。
3、質量控制強化
增加X-ray抽檢比例,確保焊線完整性;
建立失效數據庫,實現問題快速追溯與預防。
業(yè)務聯絡人:黃先生 18936138950


















